自博通(Broadcom)官网获悉,博通公司宣布推出其3.5D eXtreme Dimension系统级(XDSiP)封装平台技术。这是业界首个3.5D F2F封装技术,在单一封装中集成超过6000mm2的硅芯片和多达12个HBM内存堆栈,以满足AI芯片的高效率、低功耗的计算需求。
射频微波器件采购网(www.Datawave代理商ic-king.com)专注整合国内外厂商的现货渠道,实时查询射频微波器件代理商的真实库存,提供合理的行业价格,放心采购射频微波器件,是国内专业的射频微波芯片采购平台。

据介绍,博通的3.5D XDSiP平台在互联密度和功率效率方面较F2B方法实现了显著提升。这种创新的F2F堆叠方式直接连接顶层金属层,从而实现了密集可靠的连接,并最小化电气干扰,具有极佳的机械强度。博通的3.5D平台包括用于高效实现3D芯片堆叠的电源、时钟和信号互联的IP和专有设计流程。
Broadcom 3.5D XDSiP的关键优势
增强的互联密度:在堆叠的芯片之间实现了比F2B技术高7倍的信号密度。
更高的功率效率:通过使用3D HCB而不是平面的芯片间PHY,将芯片间接口的功耗降低了10倍。
降低延迟:在3D堆叠中,最小化了计算、内存和I/O组件之间的延迟。
紧凑的封装尺寸:使互连器和封装尺寸更小,从而节省成本并改善封装翘曲。
博通领先的F2F 3.5D XPU集成了四个计算芯片、一个I/O芯片和六个HBM模块,利用台积电先进的工艺节点和2.5D CoWoS封装技术。博通基于行业标准工具的专有设计流程和自动化方法学确保了芯片的首次成功,尽管其极为复杂。3.5D XDSiP已在关键IP块(包括高速SerDes、HBM内存接口和芯片间互连)上展示了完整的功能和出色的性能。这一成就凸显了博通在设计和测试复杂3.5D集成电路方面的专业技能。
- 甲骨文携手 AMD 布局 AI 领域:3 万 MI355X 打造巨型 AI 集群
- DeepSeek 四大影响:或将改变世界格局 开源生态重塑 AI 产业
- 美自动驾驶监督计划出炉!车企自愿披露数据,事故响应时间缩短 50%
- 2025 年新势力汽车市场竞争将更加激烈,谁能突出重围?
- 台积电 2nm 工艺制程即将量产,手机行业步入新时代
- DeepSeek 突破引发震动:美管制令遭质疑 中国 AI 生态自主化加速
- 意法半导体入选全球百强创新机构!专利储备超 1.5 万件,AIoT 领域占比 60%
- 台积电拿下决定性战役,胜利背后的关键因素
- SK 海力士完成英特尔 NAND 业务收购,产业格局或生变
- 海信电视接入 DeepSeek:行业首家尝鲜 智能语音交互体验升级
- 泛林集团三连冠!全球最具商业道德企业,碳中和目标提前至 2030 年
- 逐点半导体:以创新迎接机遇,在行业中崭露头角
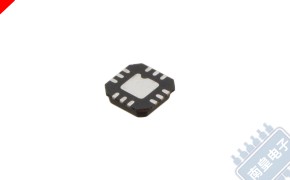 射频放大器(射频和无线)
射频放大器(射频和无线) RFI 和 EMI - 触头,簧片和衬垫(射频和无线
RFI 和 EMI - 触头,簧片和衬垫(射频和无线 通孔式电阻器(电阻器)
通孔式电阻器(电阻器) 嵌入式 > 片上系统(SoC)(集成电路(IC)
嵌入式 > 片上系统(SoC)(集成电路(IC) 固定电感器(电感器,线圈,扼流圈)
固定电感器(电感器,线圈,扼流圈) 接口 > UART(通用异步接收器发送器)(集成
接口 > UART(通用异步接收器发送器)(集成 RF 天线(射频和无线)
RF 天线(射频和无线) 光纤收发器模块(光电器件)
光纤收发器模块(光电器件) RF 配件(射频和无线)
RF 配件(射频和无线) 射频放大器(射频和无线)
射频放大器(射频和无线) 固态继电器(继电器)
固态继电器(继电器) 嵌入式 > CPLD(复杂可编程逻辑器件)(集成
嵌入式 > CPLD(复杂可编程逻辑器件)(集成























